
- ?頤光技術(shù)優(yōu)勢
- ?技術(shù)資訊
-
關(guān)于我們|
-
產(chǎn)品中心|
- 光譜橢偏儀
- 定制型橢偏儀
- 反射膜厚儀
- 自動(dòng)化膜厚量測機(jī)臺(tái)
- 膜厚傳感器
- 外延層膜厚量測設(shè)備
- 元素濃度量測設(shè)備
- 晶圓形貌測量設(shè)備
- 雙束電鏡
- 氙燈
- 配套組件
? 橢偏儀系列? 膜厚儀系列? 傳感器系列? FTIR系列? 晶圓形貌測量系列? 電鏡系列? 光學(xué)組件 -
解決方案|
- ?半導(dǎo)體行業(yè)
- ?顯示行業(yè)
- ?LED行業(yè)
- ?光伏行業(yè)
- ?玻璃蓋板行業(yè)

-
分析服務(wù)|
- ?光學(xué)小知識(shí)
- ?測試項(xiàng)目
- ?測樣申請(qǐng)
- ?測試案例
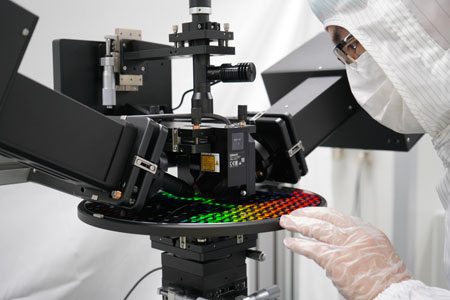
-
聯(lián)系我們























